SK海力士的先進封裝廠,目標是在2028年下半年正式投入營運。
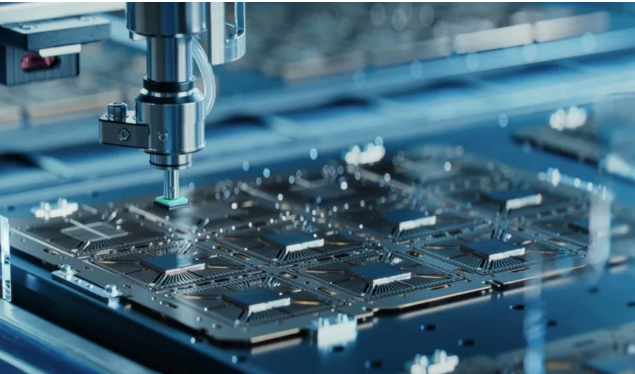
隨著人工智慧(AI)浪潮席捲全球,半導體產業的競爭核心正從單純的晶片製造,轉向更為複雜的先進封裝技術。根據媒體報導,韓國儲存器大廠SK海力士(SK hynix)正在採取一項具備戰略意義的重大投資,計畫在美國建立其首條2.5D 封裝量產線。此動作不僅象徵著SK 海力士要超越HBM(高頻寬儲存器)供應商的角色,更展現其欲掌握最先進封裝技術主導權、強化AI 半導體供應鏈地位的雄心。
根據ZDNet Korea的報導,SK海力士目前正深入討論在其位於美國印第安納州西拉法葉(West Lafayette)的新建封裝工廠中,匯入2.5D 製造產線的方案。這座工廠是SK海力士在美國境內的首座生產基地,定位為AI 儲存器專用的最先進封裝生產基地。而且,該投資案規模龐大,SK海力士先前已宣佈將投入38.7 億美元進行建設,目標是在2028 年下半年正式投入營運。
目前,2.5D 封裝技術被視為整合HBM 與高性能系統半導體(如GPU 或CPU)的核心製程之一。其技術原理是在半導體晶片與電路板(Substrate)之間插入一層被稱為“矽中介層”(Silicon Interposer) 的薄膜。而這項技術具備透過矽中介層縮短晶片間的傳輸距離,大幅最佳化電力消耗與資料處理速度,以提升效能與電力效率的優勢。尤其,目前全球AI 晶片大廠輝達(Nvidia)的高性能AI 加速器,便是透過2.5D 封裝技術將HBM 與高性能GPU/CPU 緊密整合而成,更顯示出相關市場潛力。
SK海力士認為,若能掌握2.5D 封裝的量產能力,將能全面強化其在AI 半導體封裝領域的競爭力,而不僅僅侷限於HBM 的生產。現階段,SK海力士雖然在韓國國內具備2.5D 封裝的基本技術力與研發裝置,但仍不足以支撐能對應大型系統級封裝(SiP)的量產需求,因此,報導引用消息人士的說法指出,由於現有設施難以負荷整合了HBM 的大規模AI 加速器生產,因此SK海力士正積極與封裝合作夥伴商討,在美國西拉法葉工廠建立正式的量產線。
報導強調,SK海力士預計投資能帶來以下好處:
確保供應穩定性:HBM 在交付最終客戶(如輝達)前,必須通過2.5D 封裝的品質測試(Qual Test)。在現有架構下,即使HBM 本身沒有問題,若在封裝過程中發生不良,將導致整個交貨過程延誤。
釐清責任歸屬:2.5D 封裝構造複雜,一旦出現不良品,往往難以精確判定責任歸屬於儲存器廠商或封裝廠。
挑戰台積電的壟斷地位:目前AI 加速器所需的2.5D 封裝市場事實上由台積電(TSMC)獨佔。 SK海力士若能成功建立量產線,將能向客戶提供HBM 與封裝一站式的統包(Turn-Key)服務,提升議價能力與市場佔比。
半導體業界分析人士指出,SK海力士已將“具備自有的2.5D 封裝裝置”視為極其重要的戰略課題。一旦技術趨於穩定且高度化,SK海力士將不滿足於單純的內部研發,而是會正式以此作為一項獨立業務進軍市場。另外,這項在美國的投資計畫,不僅是為了應對輝達等大客戶的需求,更是為了在未來次世代HBM 競爭中搶佔先機。隨著2028 年工廠完工,全球AI 半導體供應鏈預計將迎來一場劇烈的權力重組,而SK海力士正試圖從一名強力的元件供應商,進化為掌握核心整合技術的產業關鍵節點。
什麼是2.5D封裝?
2.5D/3D 是將多個積體電路整合到同一封裝內的封裝技術。在 2.5D 結構中,兩個或多個有源半導體晶片並排放置在矽中介層上,以實現極高的晶片間互連密度。在 3D 結構中,有源晶片通過晶片堆疊的方式整合,以實現最短的互連線和最小的封裝尺寸。
近年來,2.5D 和 3D因其在實現極高的封裝密度和高能效方面的優勢,已成為理想的晶片整合平台。
2.5D/3D IC封裝主要用於整合以下應用中的HBM:高端GPU;高端FPGA;用於資料中心和 5G 基礎設施的網路交換機/路由器;用於人工智慧訓練的人工智慧加速器。在晶片時代,2.5D 和 3D IC 封裝將在 CPU、移動 AP、矽光子學、顯示驅動 IC 等眾多應用中發揮越來越重要的作用。 (半導體產業縱橫)
